
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.
Com o rápido avanço dos dispositivos eletrônicos em direção à miniaturização, multifuncionalidade, alto consumo de energia e maior confiabilidade, surgiu a tecnologia de integração tridimensional de alta densidade para dispositivos microeletrônicos. No entanto, o desenvolvimento da integração de alta densidade é limitado pelas elevadas temperaturas de junção causadas pela concentração térmica dentro dos chips, comprometendo significativamente o desempenho e a confiabilidade do dispositivo.
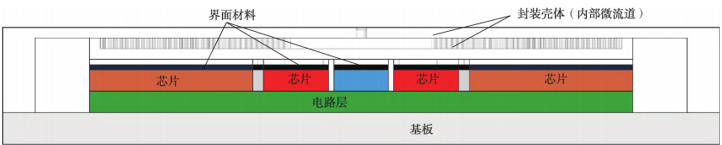
Os chips integrados apresentam estruturas multicamadas que compreendem camadas de substrato, camadas de circuito de chip, chips e placas frias de invólucro de embalagem. A placa fria do invólucro incorpora microcanais que dissipam o calor dos chips da camada do circuito por meio de transferência de calor por convecção líquida, garantindo ao mesmo tempo uma distribuição uniforme da temperatura do chip. Materiais flexíveis de interface térmica (TIM) fazem a ponte entre a placa fria do invólucro da embalagem e a camada do circuito.
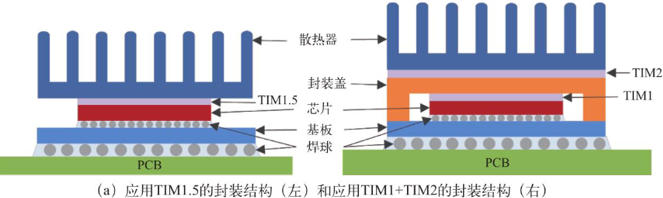
Os materiais de interface térmica (TIMs) são componentes críticos de dissipação de calor que preenchem lacunas microscópicas entre as superfícies para melhorar diretamente o desempenho térmico. Os TIMs são normalmente aplicados entre o chip e a tampa da embalagem (TIM1), o chip e o dissipador de calor (TIM1.5) e a tampa da embalagem e o dissipador de calor (TIM2). A alta condutividade térmica e a confiabilidade dos TIMs garantem uma rápida transferência de calor entre as interfaces. A abordagem predominante de gerenciamento térmico para chips de alto poder computacional ainda depende de materiais TIM1 de resistência térmica ultrabaixa para conduzir rapidamente o calor do interior do chip para o invólucro do pacote. O calor é então transferido através dos materiais TIM2 para uma placa de resfriamento líquido, que o dissipa rapidamente para o ambiente externo através do rápido fluxo de seu fluido de resfriamento interno.

Enviar e-mail para este fornecedor

Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.

Fill in more information so that we can get in touch with you faster
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.